Технология Intel EMIB заложила фундамент партнерства компании с AMD и реализации проекта Kaby Lake-G. Основой для создания готовящегося к выпуску чипа Lakefield стала технология Intel Foveros, позволяющая выстраивать кристаллы вертикально. Теперь Intel пытается объединить EMIB и Foveros в так называемую технологию "co-EMIB" с еще более развитым интерфейсом ODI.
«Обе технологии повысят эффективность продуктов и их энергопотребления, способствуя полному переосмыслению архитектуры системы, – говорится в блоге Intel. – Обе они предлагают передовые решения с точки зрения размещения и подключения чипов, не ограничиваясь совершенствованием электронных компонентов или микроархитектуры в целом».
Неясно пока, какая из технологий будет предложена рынку и на какие продукты это окажет влияние. Известно, однако, где уже сейчас используются EMIB и Foveros. Напомним, EMIB является основой революционного совместного проекта AMD и Intel Kaby Lake-G, представленного в 2017 году, и концепции чиплетов. Foveros – это технология вертикальной компоновки чипов, которая найдет применение в готовящемся к выпуску продукте Lakefield, объединяющем чипы Atom и Core для приложений с пониженными требованиями к процессорным ресурсам.
Зачем нужны EMIB и Foveros
Зачем нам нужны EMIB и Foveros? Дело в том, что размещать всю систему чипов на одном кристалле оказывается слишком дорого. Используя сочетание старых технологических процессов, чипы можно изготавливать дешевле. А наличие производственных дефектов может привести к тому, что огромный и дорогой монолитный кристалл окажется совершенно бесполезным. В такой ситуации множество небольших и более дешевых чипов, связанных друг с другом высокоскоростными соединениями, представляется разумным компромиссом. EMIB и Foveros помогают добиться как раз этого.
Технология Embedded Multi-die Interconnect Bridge или EMIB позволяет состыковать контакты ввода-вывода одного чипа с контактами другого, формируя оптимизированное межкомпонентное соединение двух чипов, что позволяет расширять блок чипов в двух измерениях, не жертвуя при этом производительностью. Для Intel это является также способом сэкономить деньги за счет реализации части функционала с использованием более старых и дешевых технологий, тогда как другие ядра изготавливаются по новейшей 10-нанометровой технологии, обеспечивающей максимальную производительность. EMIB связывает все это в единое целое.
В 2018 году Intel представила мир технологии Foveros, которая позволяет размещать чипы в том числе и вертикально друг над другом. Foveros помогает конструкторам укладывать маломощные процессоры один поверх другого и даже дополнять их памятью. В январе компания указала, что Foveros станет тем связующим элементом, который позволит связать чипы Lakefield друг с другом. В мае Intel подробно рассказала об объединении архитектур Sunny Cove и Tremont.
Расширение вниз, вверх и за пределы
Поняв, как работают технологии EMIB и Foveros, будет проще понять, как EMIB их объединяет. Co-EMIB позволяет осуществлять горизонтальное соединение двух или более элементов Foveros, выводя производительность, по сути, на уровень одного чипа. Есть возможность также подключать память и даже аналоговую логику, обеспечивая при этом более высокую пропускную способность и пониженное энергопотребление. Выстраивание чипов Foveros можно сравнить с выстраиванием этажей небоскреба, а co-EMIB выступает здесь в качестве перехода между двумя башнями Foveros.
В Intel рассказали и об оптимизированной версии комбинации Foveros-EMIB: Omni-Directional Interconnect или ODI. Верхний чип по аналогии с EMIB может поддерживать горизонтальные соединения с другими чиплетами. Кроме того, по аналогии с Foveros поддерживается вертикальная связь through-silicon vias (TSV) с кристаллами, расположенными ниже.
Металлические соединения между различными слоями субстрата позволяют также переносить энергию питания через субстрат независимо от того, какая логика находится на верхнем кристалле. Intel делает эти соединения даже крупнее обычных, обеспечивая передачу дополнительной энергии благодаря уменьшению сопротивления.
И, наконец, Intel представила новый интерфейс MDIO между кристаллами. На презентации Semicon West было заявлено, что в 2020 году MDIO обеспечит скорость в 5,4 Гбит/с по одному контакту.
Ни одна из перечисленных технологий не окажет непосредственного влияния на выбор пользователем своего очередного ПК. Но все это предоставит Intel большую гибкость в проектировании, обеспечивая увеличение производительности за счет объединения логических схем новыми способами. Поскольку действие закона Мура замедляется (а спрос на постоянные улучшения – нет), Intel и ее конкурентам приходится изыскивать новые креативные ходы.
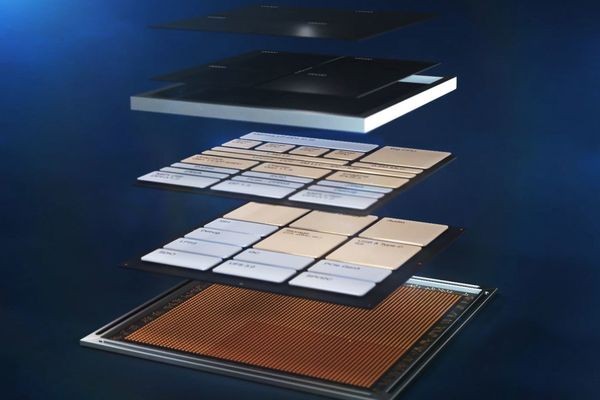
.jpg)